
多晶硅栅极的形成方法.pdf

黛娥****ak





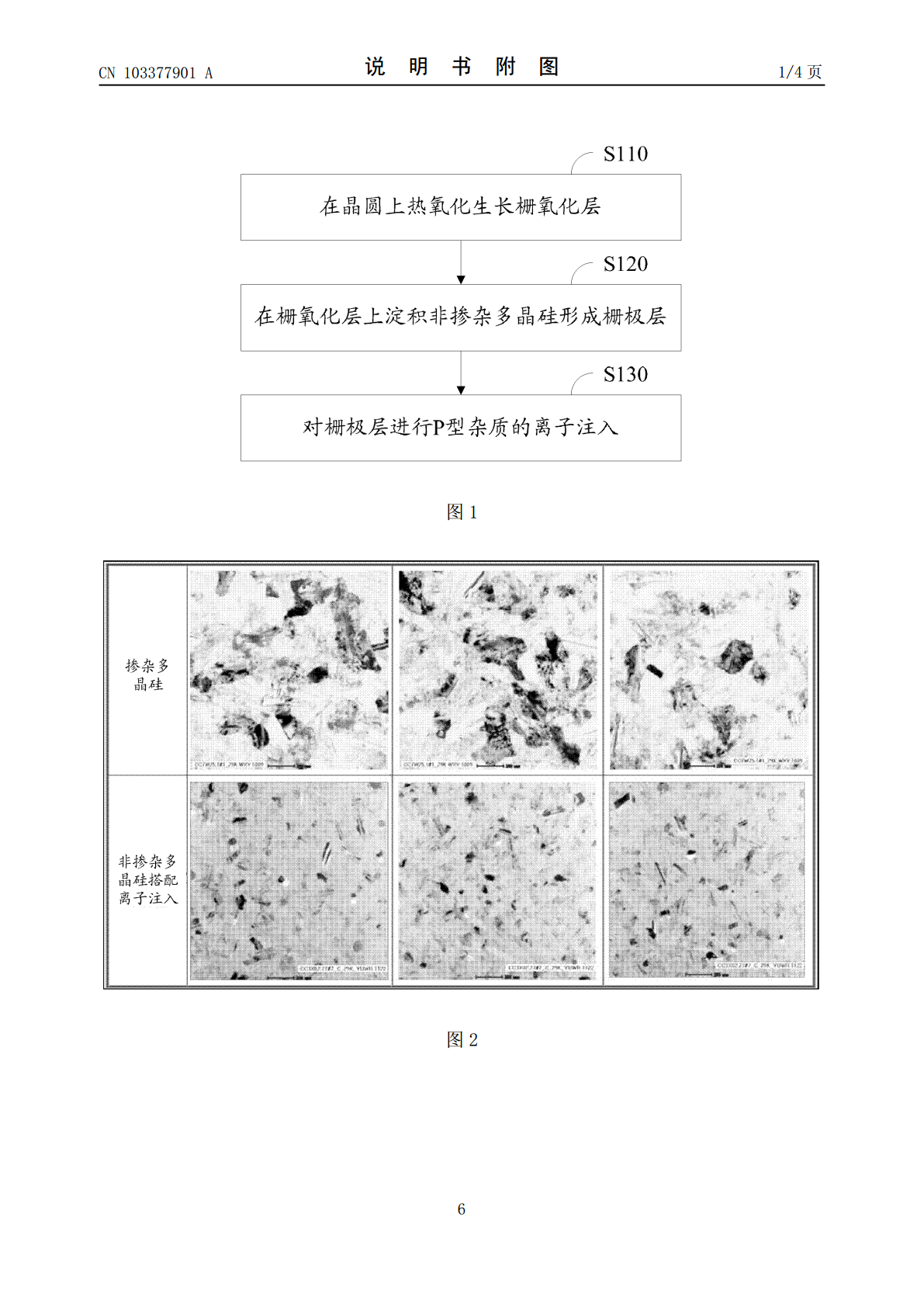


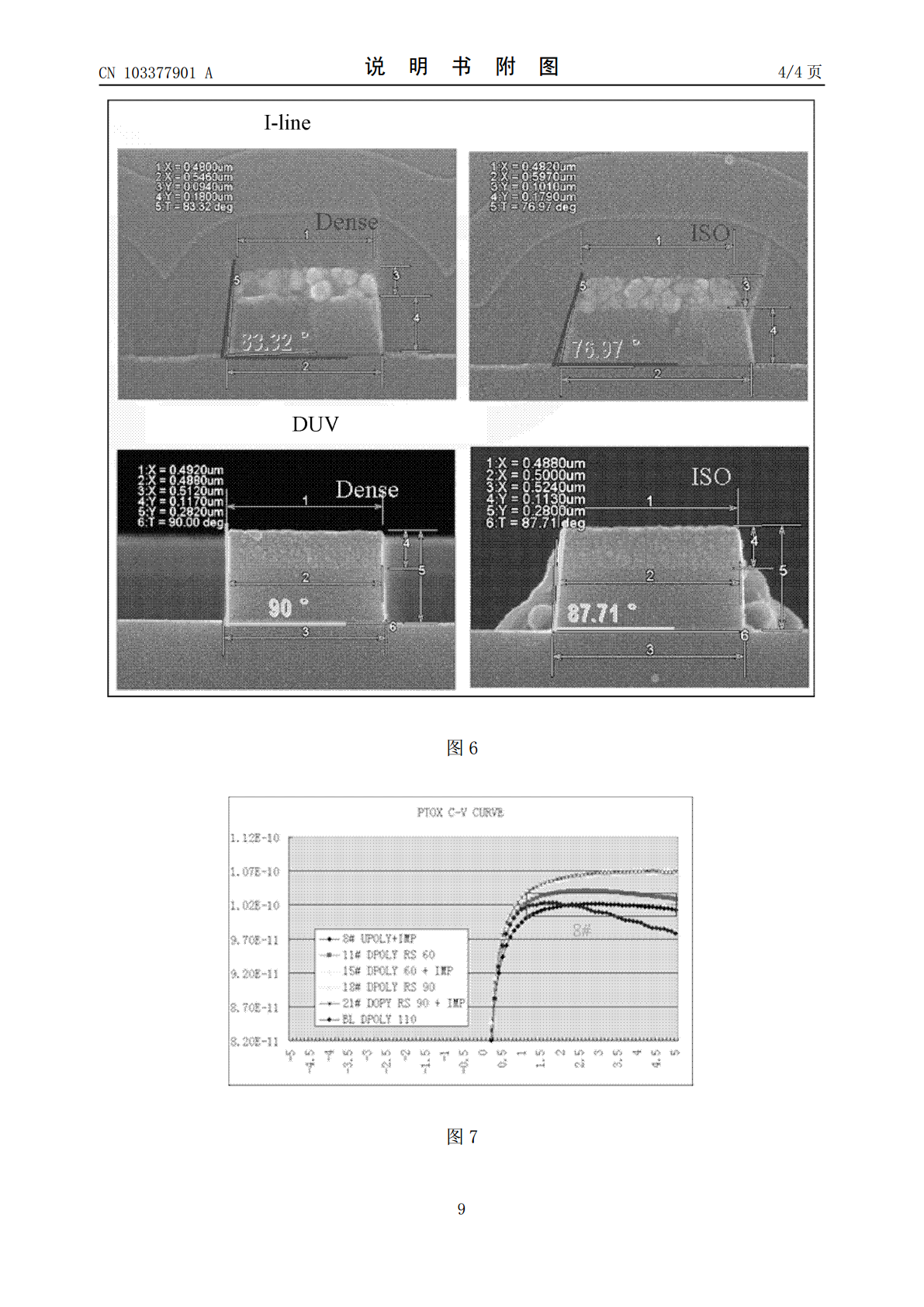
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

多晶硅栅极的形成方法.pdf
本发明涉及一种多晶硅栅极的形成方法,包括:提供在衬底上形成了栅氧化层、在栅氧化层上形成了多晶硅层的晶圆;对所述多晶硅层进行蚀刻,形成多晶硅栅极;在所述晶圆表面形成覆盖所述衬底和多晶硅栅极的保护层;蚀刻所述保护层,将所述多晶硅栅极上方以及所述衬底表面的保护层去除,所述多晶硅栅极侧面余留的保护层形成侧墙;对所述晶圆进行湿氧氧化,在所述衬底表面形成氧化层。本发明能够将多晶硅残留氧化成不导电的硅氧化物,从而消除多晶硅残留导致的导电性异常缺陷。

多晶硅栅极的形成方法.pdf
本发明涉及一种多晶硅栅极的形成方法,包括下列步骤:在晶圆上热氧化生长栅氧化层;在所述栅氧化层上淀积非掺杂多晶硅形成栅极层;对所述栅极层进行P型杂质的离子注入。本发明将传统的栅极材料由传统的掺杂多晶硅替换成非掺杂多晶硅搭配离子注入,多晶硅的晶粒尺寸显著减小。而晶粒尺寸减小后,在单个运算放大器中,对开启电压(Vt)的扰动降低,因此对运算放大器失配的影响大幅减小。由于主流的掺杂炉管(furnace)都可以实现非掺杂淀积,并且离子注入工艺没有技术难度,因此本发明通用性高、成本较低,且几乎不会增加整体的作业时间。

一种多晶硅栅极的制造方法及多晶硅栅极.pdf
本发明提供了一种多晶硅栅极的制造方法及多晶硅栅极,其中,多晶硅栅极的制造方法包括:在衬底上依次生成栅氧化层、多晶硅层和氮化硅层;对所述氮化硅层和所述多晶硅层进行光刻和刻蚀,且所述多晶硅层上被刻蚀的位置保留预设厚度的余量;对外露的所述多晶硅层进行氧化,得到氧化层;去除所述氮化硅层,并在露出的所述多晶硅层上生成硅化物,形成多晶硅栅极。本发明提供的方案通过在刻蚀多晶硅时保留一定的余量,然后通过氧化将其转化为二氧化硅(氧化层),能够保证多晶硅层下方任何位置处的栅氧化层都不会被损伤到,简化了制作工艺;同时保留了完整

栅极的形成方法.pdf
一种栅极的形成方法,包括:提供衬底并设置第一区域以及第二区域;在衬底上分别形成第一栅极、蚀刻停止层以及层间介质层;进行第一平坦化处理,以露出第一区域的第一栅极,以及第二区域的蚀刻停止层;去除露出的蚀刻停止层直至露出第二区域的第一栅极;去除第一区域以及第二区域的第一栅极;在所述第一区域以及第二区域中第一栅极的位置处形成第二栅极。本发明具有以下优点:通过使残留在栅极上的蚀刻停止层暴露出,并选择性的去除所述蚀刻停止层,以将被残留的蚀刻停止层遮挡的栅极暴露出来,方便后续去除所述栅极的步骤的进行。

栅极的形成方法.pdf
本发明提出一种栅极的形成方法,在对多晶硅层进行预注入之后,先形成较薄且较为致密的第一掩膜层,再形成较为疏松的第二掩膜层,接着再进行刻蚀,由于预注入之后,残留在多晶硅层表面的离子会渗透出第一掩膜层与第二掩膜层,避免离子在多晶硅层和第一掩膜层的交界处形成团聚空洞,使后续刻蚀正常进行,从而避免对半导体衬底造成损伤。
