
碳化硅外延晶片的制造方法及制造装置.pdf

是你****辉呀







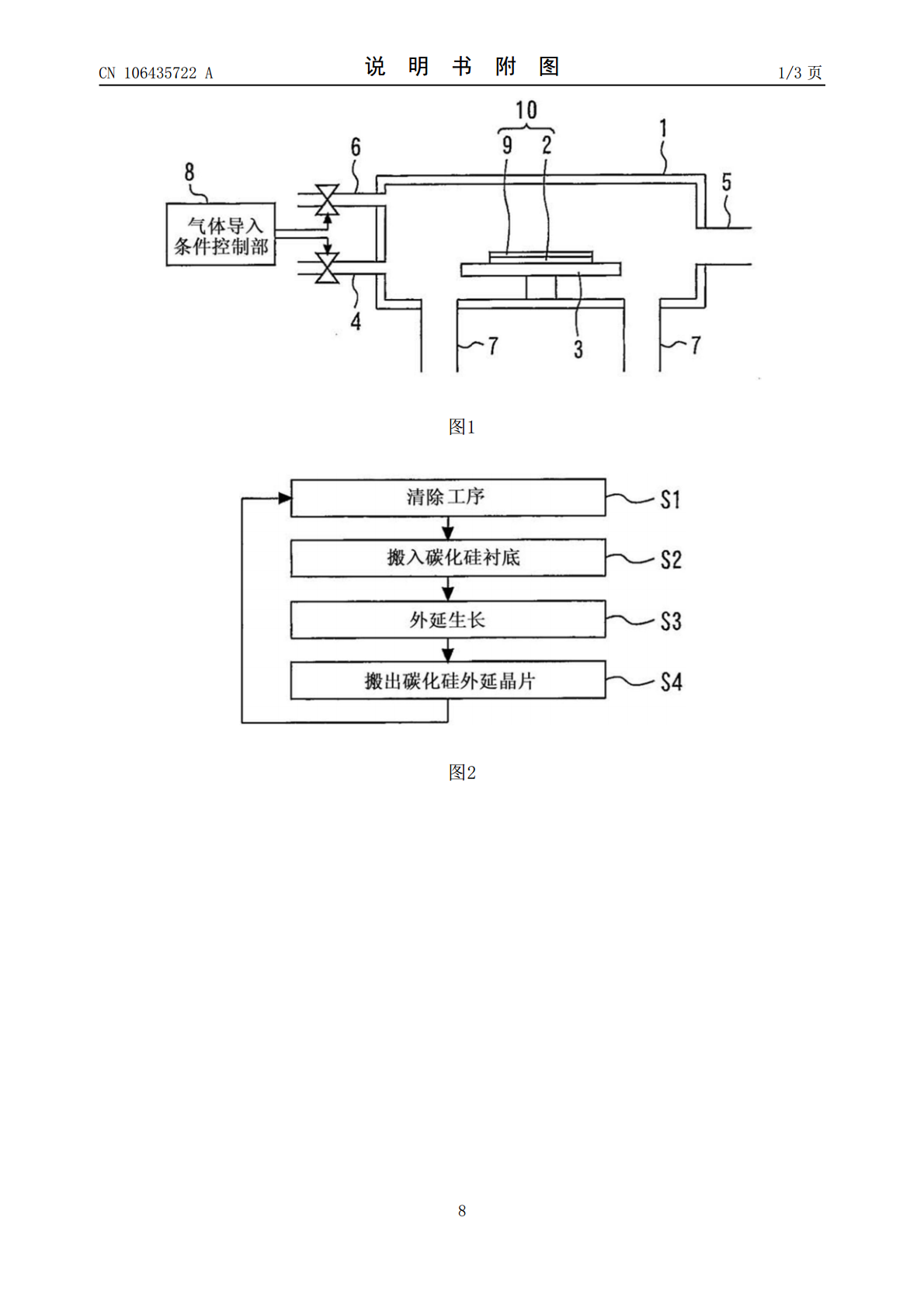
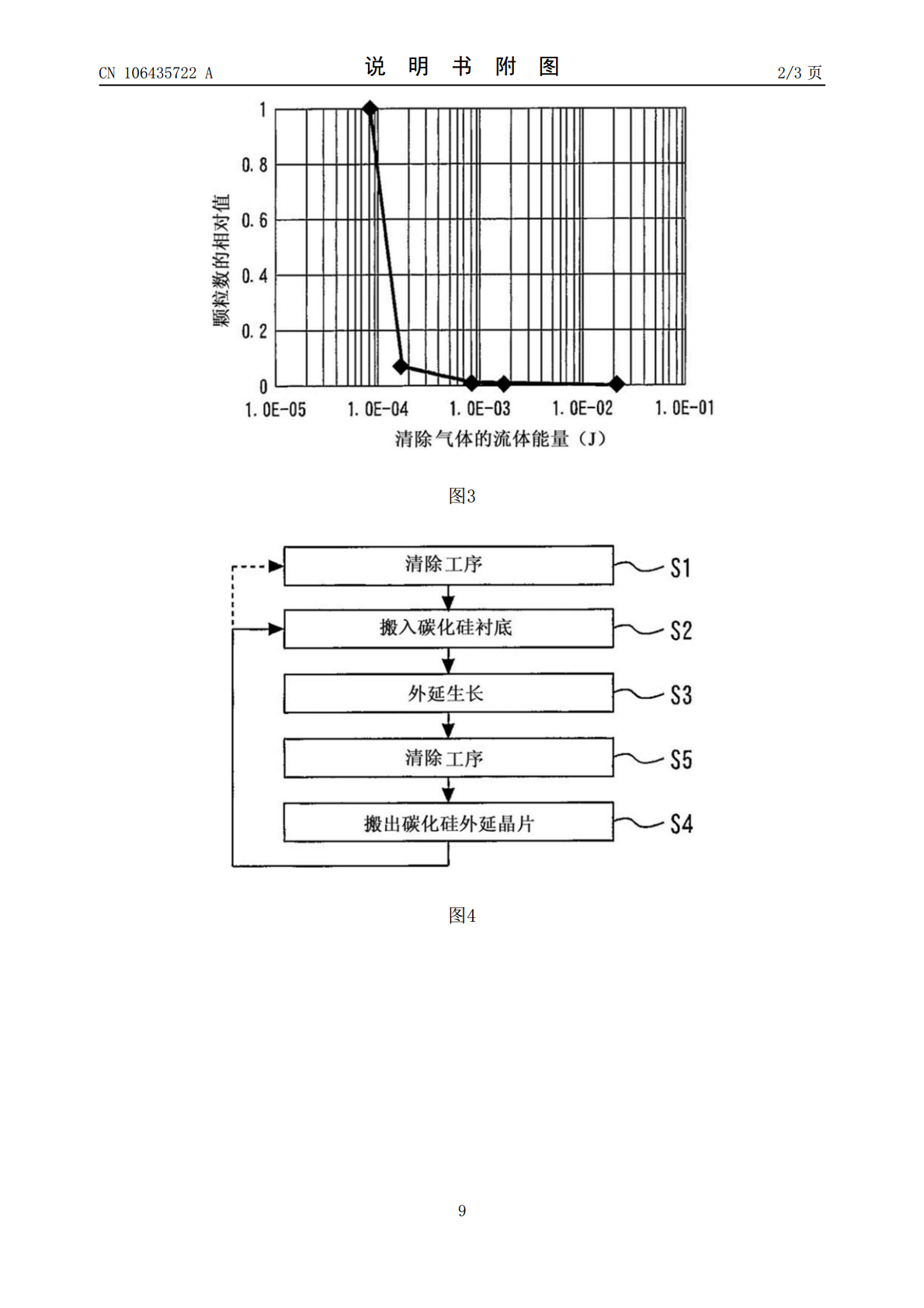

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

碳化硅外延晶片的制造方法、碳化硅半导体装置的制造方法及碳化硅外延晶片的制造装置.pdf
得到能够对晶体缺陷少的碳化硅外延晶片进行制造的碳化硅外延晶片的制造方法、碳化硅半导体装置的制造方法及碳化硅外延晶片的制造装置。使在生长炉(1)的内壁附着的碳化硅进行氮化、氧化或者氮氧化而得到稳定化。接下来,将衬底(2)搬入至生长炉(1)内。接下来,将工艺气体导入至生长炉(1)内,在衬底(2)之上使碳化硅外延层进行生长而制造碳化硅外延晶片。

碳化硅外延晶片的制造方法及制造装置.pdf
得到一种制造方法及制造装置,该制造方法及制造装置能够制造晶体缺陷少的碳化硅外延晶片,而不会损伤生长炉内的部件、晶片托架。将清除气体导入至生长炉(1)内而将附着于生长炉(1)的内壁面的树枝状碳化硅去除。在导入清除气体后,将碳化硅衬底(2)搬入至生长炉(1)内。将工艺气体导入至生长炉(1)内,在碳化硅衬底(2)之上使碳化硅外延层(9)生长而制造碳化硅外延晶片(10)。将具有大于或等于1.6E-4[J]的流体能量的清除气体导入至生长炉(1)内。

外延碳化硅晶片的制造方法.pdf
本发明提供在SiC基板上使SiC外延生长来制造外延SiC晶片时得到具有与以往相比进一步降低了层叠缺陷以及彗星型缺陷的高品质外延膜的外延SiC晶片的制造方法。上述外延碳化硅晶片的制造方法的特征在于,在外延生长的开始前流入到生长炉中的生长前气氛气体含有氢气,余量为不活泼气体和不可避免的杂质,其中,上述氢气的含量相对于不活泼气体为0.1~10.0体积%。

外延碳化硅晶片的制造方法.pdf
本发明的课题在于,再现性良好地制造台阶聚并少且具有高品质的碳化硅单晶薄膜的外延碳化硅晶片。为了解决上述课题,在外延生长炉内的碳化硅单晶基板的蚀刻处理中使用氢气载气和硅系材料气体,在蚀刻处理结束后还在流入这些气体的状态下进行外延生长条件的变更,条件稳定后导入碳系材料气体,进行外延生长。

外延晶片的制造方法及装置.pdf
一种在进行多站式处理的情况下能够使外延晶片的品质稳定的外延晶片的制造方法和装置。具有:具有石英制的上侧拱顶(12)的单片式的外延生长炉(1)、载置晶片(W)的承载器(16)、向外延生长炉的腔(11)内供给反应气体或清洗气体的气体供给系统(3)、加热腔内的卤素灯(15)、检测晶片的表面的温度的红外线放射温度传感器(4)、和控制加热器的输出以使得检测到的温度为规定温度范围且控制气体供给系统的控制器(5);控制器将结束清洗处理后直到将第一次的晶片投入腔内为止的待机时间设定为加热器的输出的变动率落入规定范围的时间
