
外延炉冷却系统及冷却方法.pdf

一只****懿呀








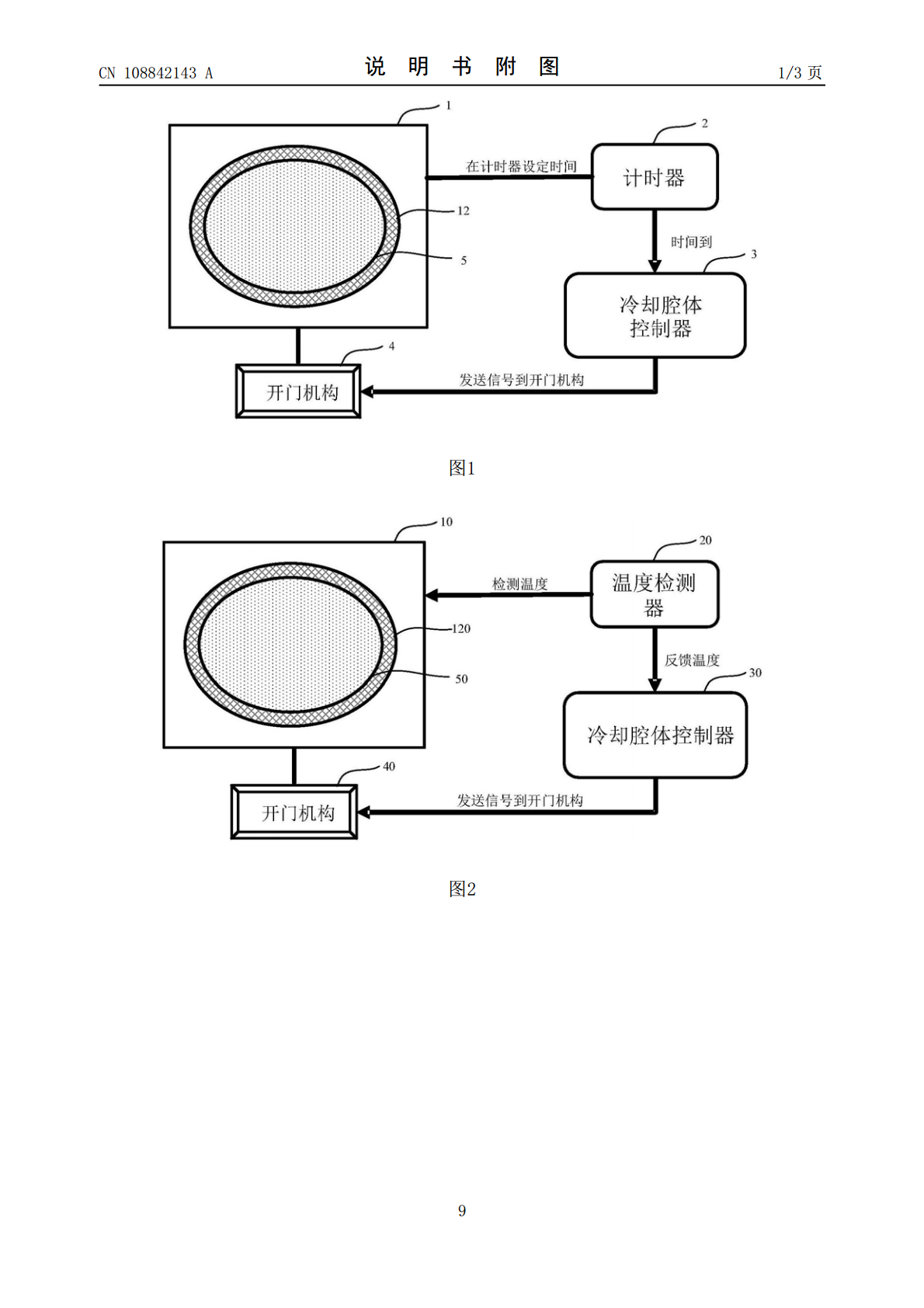
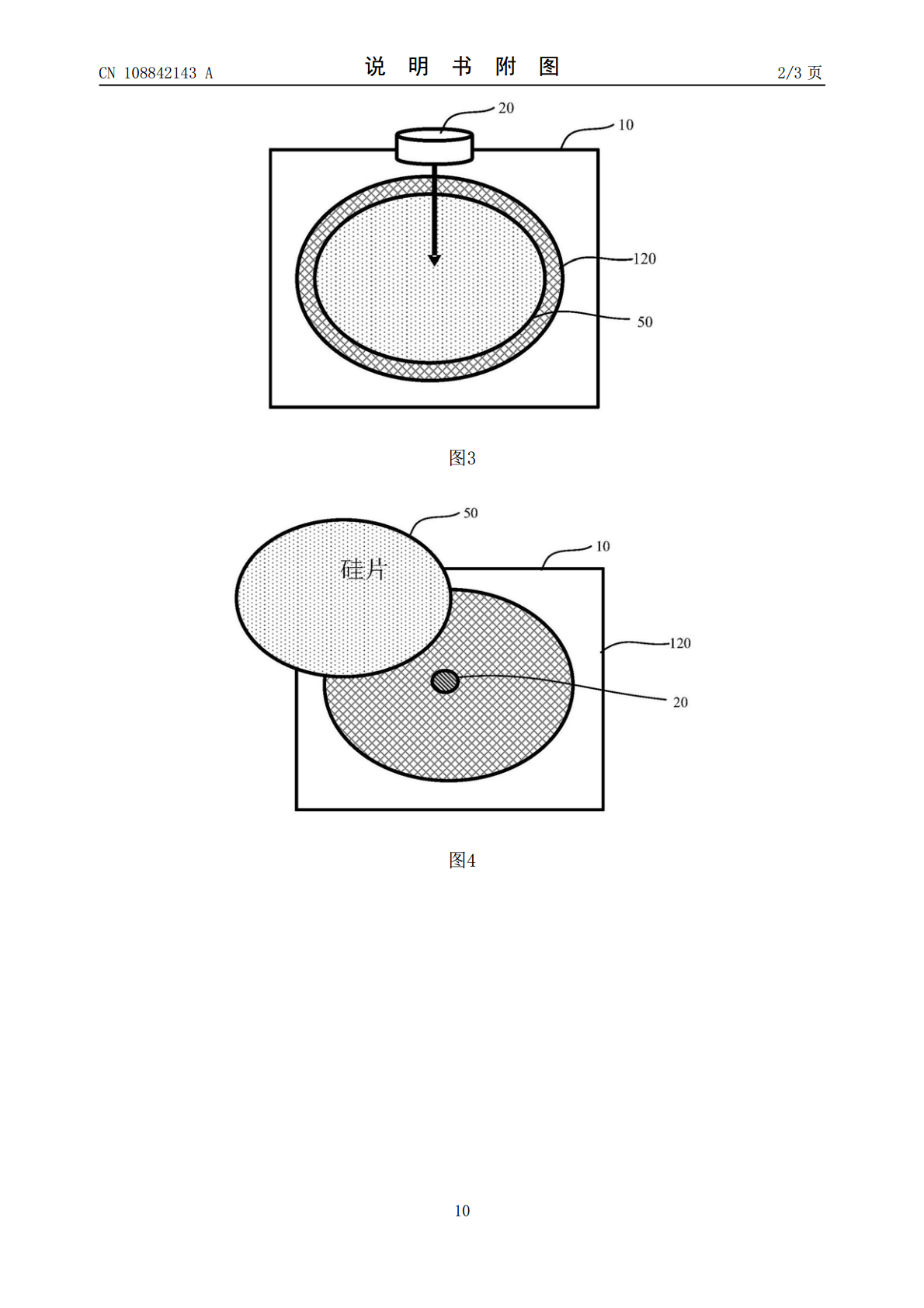
亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

外延炉冷却系统及冷却方法.pdf
本发明提供了一种外延炉冷却系统及冷却方法,所述外延炉冷却系统包括:冷却腔体、温度检测器以及冷却腔体控制器,其中所述冷却腔体用于冷却放置于其内的晶圆,温度检测器用于检测放置于所述冷却腔体内晶圆的温度,并将所述晶圆的实际温度传输至所述冷却腔体控制器,所述冷却腔体控制器具有一预设温度,并实时接收所述实际温度,并将所述实际温度与设定温度进行比较,如果所述实际温度大于所述设定温度,则控制所述冷却腔体继续冷却,如果所述实际温度等于或小于所述设定温度,则控制所述冷却腔体结束冷却,由此可以有效控制所述晶圆的冷却温度而及时

外延炉吹扫冷却系统、方法、装置、电子设备及存储介质.pdf
本发明涉及外延生长技术领域,具体公开了一种外延炉吹扫冷却系统、方法、装置、电子设备及存储介质,其中,系统包括:冷却室,用于放置外延片且内部充满用于对外延片进行吹扫冷却的吹扫气体;气体温度计,用于获取吹扫气体的第一温度信息;温度调节机构;测温计,用于获取外延片的第二温度信息;气体循环机构;控制器,用于控制吹扫气体进行循环流动而对外延片进行循环吹扫冷却,并根据第二温度信息控制温度调节机构调节吹扫气体的第一温度信息以使外延片逐渐降温;该系统根据第二温度信息控制温度调节机构调节吹扫气体的第一温度信息,防止吹扫气体

一种外延炉晶片冷却系统、方法、电子设备及存储介质.pdf
本申请涉及晶片冷却技术领域,具体提供了一种外延炉晶片冷却系统、方法、电子设备及存储介质,其包括:预抽真空腔;供气装置,安装在所述预抽真空腔上,所述供气装置用于释放吹扫气体;冷却装置,设置在所述预抽真空腔内,用于冷却所述吹扫气体;第一测温装置,用于测量所述晶片的温度;控制器,用于控制所述供气装置释放所述吹扫气体以冷却所述晶片,还用于在所述晶片的温度小于或等于预设的第一阈值时,控制所述冷却装置冷却所述吹扫气体;在不发生晶片翘曲的前提下,通过控制吹扫气体的温度以实现使晶片和与晶片接触的吹扫气体保持一定的温度差,

一种中频炉冷却系统及冷却方法.pdf
本实发明公开了一种中频炉冷却系统及冷却方法,所述的冷却系统包括内循环系统和外循环系统;其中,内循环系统包括内循环水箱、内循环泵、冷却装置和测温装置;外循环系统包括外循环水箱、外循环泵、喷淋装置;内循环泵进口与内循环水箱连接,冷却装置出口与线圈和配电系统连接;外循环水箱位于冷却装置的下方,喷淋装置位于冷却装置的上方。其冷却的方法分内循环冷却和外循环冷却,内循环冷却采用纯净水封闭循环水冷却线圈和配电系统,外循环冷却采用喷淋换热方式对内循环水进行冷却。本发明可有效防止中频炉线圈和配电系统结垢、堵塞和短路,可显著

一种炭化炉的冷却系统及冷却方法.pdf
本发明提供一种炭化炉的冷却系统及冷却方法,炭化炉的冷却系统包括:储水槽、炭化炉以及板式换热器;其中,炭化炉的进水口通过管道与储水槽的出水口连通;炭化炉的出水口通过管道与板式换热器的第一进水口连通;板式换热器的第一出水口与储水槽的第一进水口通过管道连通;储水槽的进出水口处、炭化炉的进出水口处以及板式换热器的进出水口处均设置有第一阀门;当所述第一阀门均打开时,储水槽内的循环水通入炭化炉中,对炭化炉进行降温,得到温度升高的循环水,温度升高的循环水通过炭化炉的出液口流入到板式换热器中降温,并将降温后的循环水排入储
