
一种Cu/石墨烯薄膜层状复合材料及其制备方法.pdf

mm****酱吖





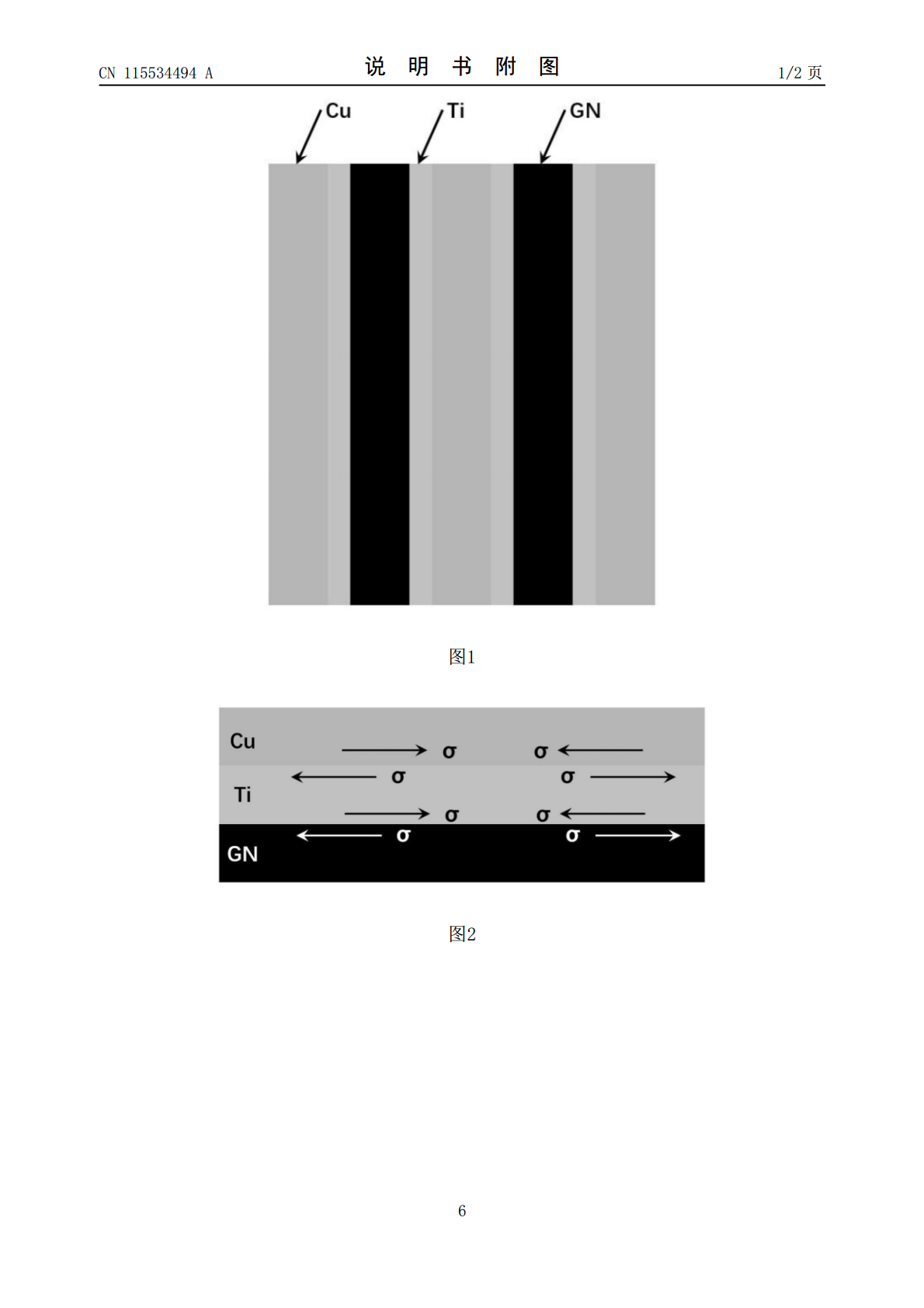
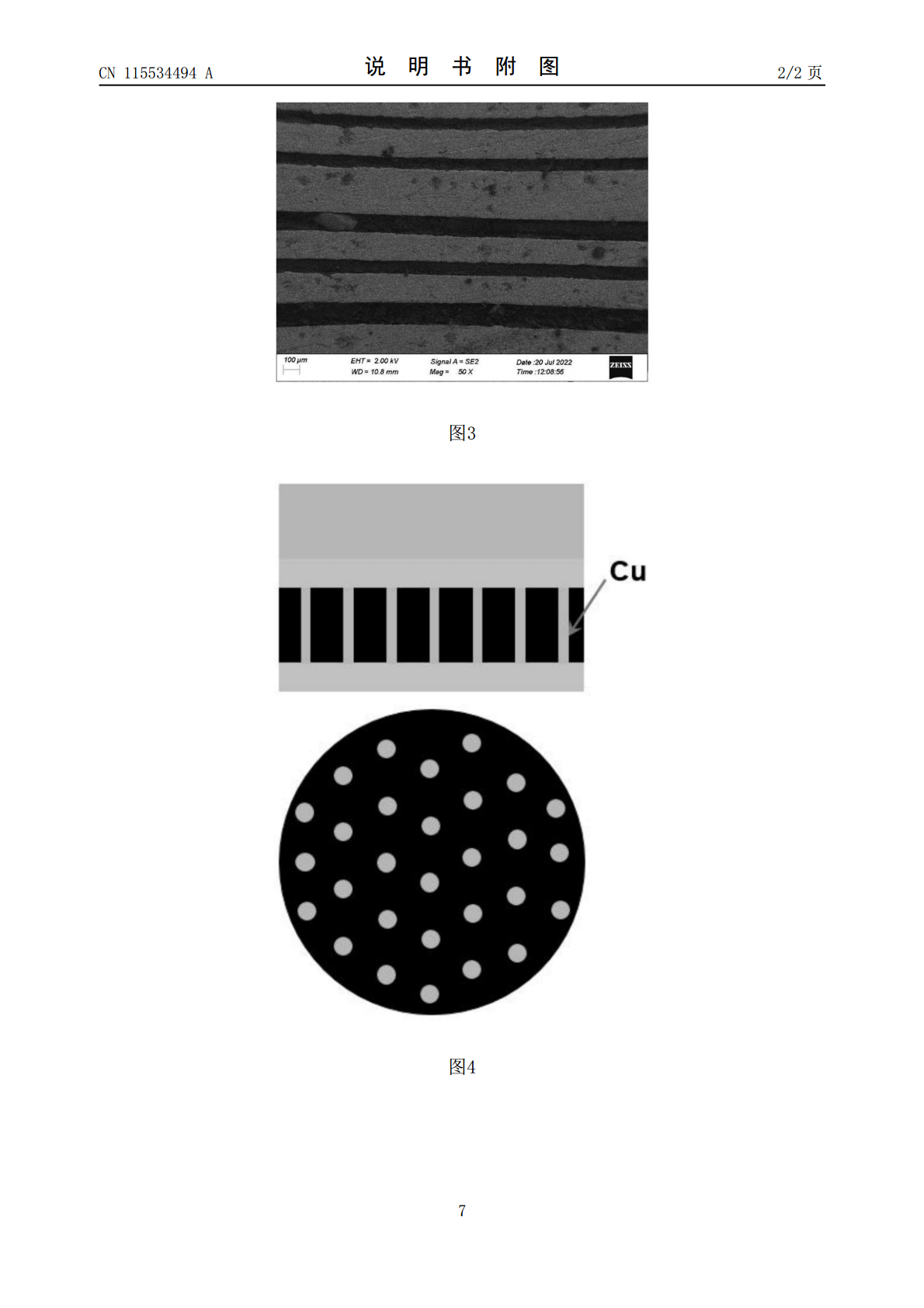
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种Cu/石墨烯薄膜层状复合材料及其制备方法.pdf
本发明涉及高导热铜基电子封装材料技术领域,公开了一种Cu/石墨烯薄膜层状复合材料的制备方法,其特征在于,包括步骤如下:步骤一:将铜箔、钛箔、石墨烯薄膜加工成直径30mm的圆片,然后使用打孔器在圆片上打孔;将上述打孔后的圆片在盐酸溶液中进行超声酸洗,然后用无水乙醇洗涤后,在烘干箱里进行烘干;步骤二:将步骤一所制得的圆片按照Cu‑Ti‑GN‑Ti的顺序进行装模;步骤三:步骤二中的模具提前预压10MPa后,置于烧结炉腔,进行烧结。本发明中层状材料选用Cu作为骨架保证了材料具有一定的强度,Cu和石墨烯一起作为散热

石墨烯铜层状复合薄膜材料的制备方法.pdf
本发明涉及材料技术领域,具体而言,涉及一种石墨烯铜层状复合薄膜材料的制备方法。所述方法包括:a)将表面处理过的至少两层铜箔叠放于支撑架上,相邻两层铜箔互相基本平行,且不互相接触;b)使用含碳气体在所述铜箔表面沉积石墨烯薄膜;c)高温处理以使沉积有沉积石墨烯薄的铜箔在高温和重力作用下发生形变与下层铜箔接触成型。本发明通过在高温和重力作用下使表面沉积石墨烯薄膜的铜箔能够在更为柔和的条件下缓慢接触,在此过程中铜箔产生的形变较小,且不易产生褶皱和弯折,复合所得材料中层状分布均匀,使该材料的性能得到最大化提升,易于

一种石墨烯薄膜及其制备方法.pdf
本发明涉及一种石墨烯薄膜的制备方法,其包括以下步骤:(1)将氧化石墨烯分散于一溶剂中,得到一混合物;(2)将该混合物倒入刮膜机中并于一基底上以速度V进行连续化刮膜,并将刮膜后得到的膜层连同基底以速度V送入鼓风烘道烘干,得到一带有基底的氧化石墨烯薄膜;(3)将所述带有基底的氧化石墨烯薄膜以速度V连续送入管式炉内并于惰性气氛下进行石墨化处理以还原氧化石墨烯并修复其表面的结构缺陷,得到带有基底的石墨烯薄膜;(4)将从管式炉出来的所述带有基底的石墨烯薄膜进行滚压以及剥离基底,得到石墨烯薄膜。本发明还提供一种石墨烯

一种石墨烯薄膜及其制备方法.pdf
本发明型公开了一种石墨烯,它是呈曲面状且包裹在泡沫镍表面的高质量石墨烯薄膜。同时公开了一种石墨烯薄膜的制备方法,包括:将泡沫镍放入管式炉,在氩氢混合气体的气氛中通过CVD法制备石墨烯,其中氩氢混合气体中氢气占10%,在整个反应过程中混合气体流量为400sccm,用乙醇作为碳源,在1000℃的环境中反应10分钟。本发明用乙醇做为碳源,采用了CVD法制备石墨烯,原料易得,成本较低,反应时间短,操作过程简单易控,制得的石墨烯薄膜具有优异的纯度,较好的机械性能和较高的柔性及导电性。

一种层状石墨烯/钛复合材料的制备方法.pdf
本发明涉及一种层状石墨烯/钛复合材料的制备方法,属于金属基复合材料制备技术领域。所述方法是将含有石墨烯的挥发性浆液均匀涂覆到片状纯钛或钛合金基体一个表面上,然后将涂覆石墨烯的基体一层一层叠加起来,使片状纯钛或钛合金与石墨烯涂层进行交替堆叠,再进行放电等离子烧结以及热处理,获得强塑性匹配优异的层状石墨烯/钛复合材料。本发明所述方法的工艺简单可行,能耗低,无污染,效率高,易于实现大规模生产;而且该方法能够使石墨烯本征结构保留完好,所制备的石墨烯/钛复合材料在层状方向还可以实现石墨烯连续分布,有利于进一步开发其
