
一种碳化硅MOSFET结构及其制造方法.pdf

一条****ee









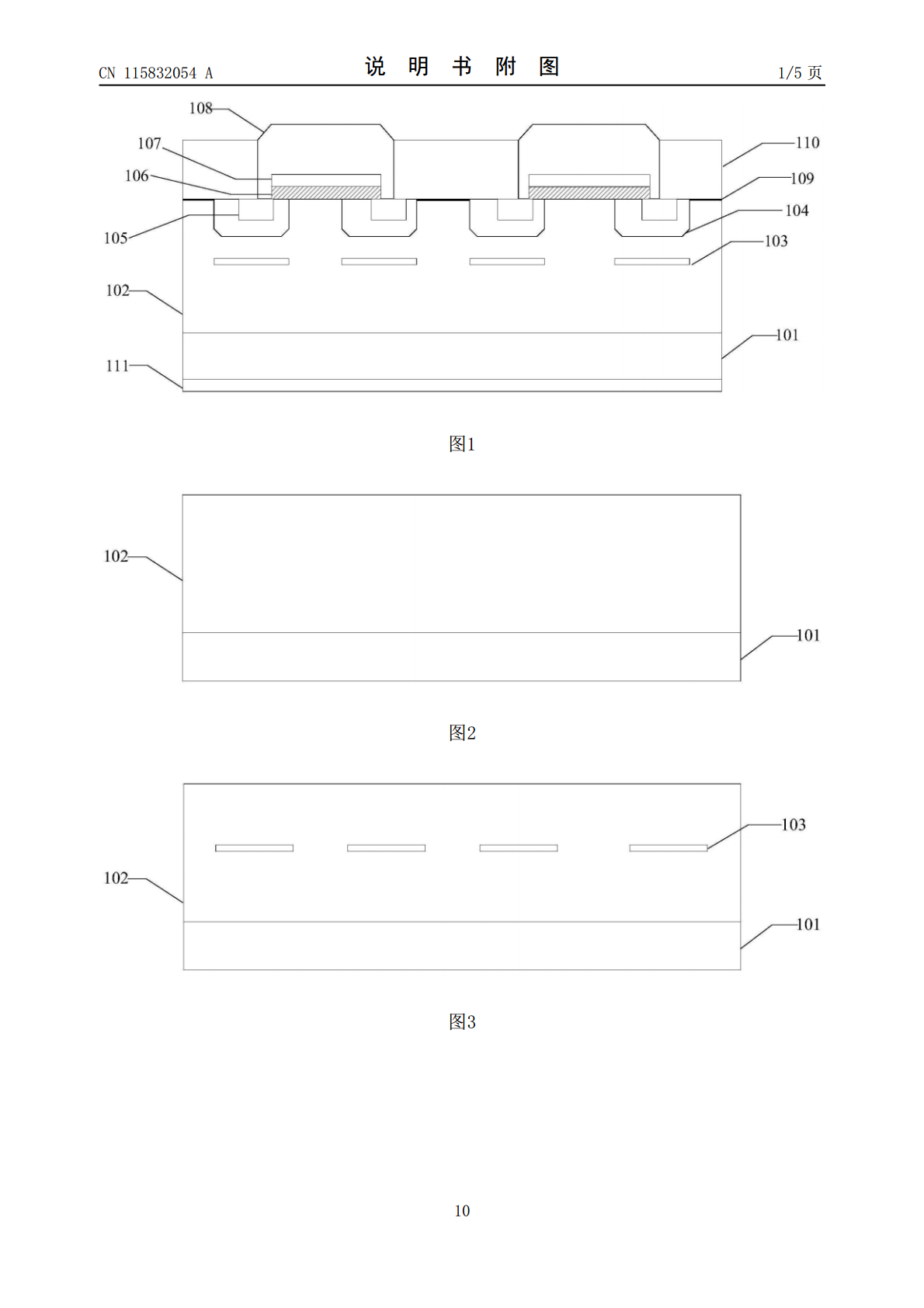
亲,该文档总共14页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种碳化硅MOSFET结构及其制造方法.pdf
本发明提供一种碳化硅MOSFET结构及其制造方法,在碳化硅MOSFET结构中,通过在碳化硅外延层中,在所述P‑well区的正下方形成超薄的高掺杂N+Buffer区或者深能级杂质或者SiO

一种碳化硅MOSFET及其制造方法.pdf
本发明涉及半导体器件制造技术领域,公开了一种碳化硅MOSFET及其制造方法,其中碳化硅MOSFET包括碳化硅衬底,碳化硅衬底的底面和顶面分别设有漏极金属层和漂移层;漂移层的内部设有屏蔽层;漂移层的顶面向下开设有沟槽,沟槽向下延伸到屏蔽层上,沟槽的横向竖截面为U型状;沟槽内设有栅极绝缘层,栅极绝缘层上从下往上依次设有屏蔽栅和栅极,屏蔽栅和栅极间隔设置,屏蔽栅的横向竖截面为U型状;在实际使用时,通过让屏蔽层包裹住栅极绝缘层的下部,从而构建PN结,能将栅极绝缘层的耐压分担到屏蔽层上,从而提高了采用U型屏蔽栅的功

一种碳化硅MOSFET器件及其制造方法.pdf
本申请实施例公开了一种碳化硅MOSFET器件的制造方法,包括在漏极上形成第一掺杂类型的衬底;在衬底上形成第一掺杂类型的漂移区;在漂移区上形成多个第二掺杂类型的体区;淀积/生长场氧化层,特别地,在A多晶栅极区有场氧化层遮挡;JFET注入,使得:邻近A多晶栅极区的漂移区没有JFET注入,而邻近B多晶栅极区内的漂移区有JFET注入;移除场氧化层,并进行:有源源蚀刻、栅极层生长、多晶硅沉积、多晶硅蚀刻;源CT和栅CT刻蚀,P+注入;金属沉积和蚀刻;以及钝化/聚酰亚胺沉积和蚀刻。本发明在不改变工艺步骤且不增加工艺流

碳化硅MOSFET器件及其制造方法.pdf
公开了一种碳化硅MOSFET器件及其制造方法,方法包括:在衬底的第一表面上形成外延层;在外延层中形成源区;在外延层中形成体区;在外延层的第一表面上形成栅极结构,栅极结构包括栅介质层,栅极导体以及层间介质层;在层间介质层中形成开口以暴露源区的表面;以及形成源极接触,源极接触形成在层间介质层的表面上并且经由开口与源区相连接,其中,利用离子注入的倾角控制使得体区的横向延伸范围大于源区的横向延伸范围,使得体区位于源区的周边部分形成横向延伸的沟道,栅极导体的至少一部分位于沟道上方。本申请的碳化硅MOSFET器件的制

一种沟槽MOSFET器件的制造方法及其结构.pdf
(19)国家知识产权局(12)发明专利申请(10)申请公布号CN116031153A(43)申请公布日2023.04.28(21)申请号202310311272.2(22)申请日2023.03.28(71)申请人江苏长晶科技股份有限公司地址210000江苏省南京市江北新区研创园腾飞大厦C座13楼(72)发明人杨国江卓宁泽(74)专利代理机构南京华讯知识产权代理事务所(普通合伙)32413专利代理师仝东凤(51)Int.Cl.H01L21/28(2006.01)H01L21/336(2006.01)H01L
