
一种用于气相外延生长的防返流气体输运装置及方法.pdf

一只****呀9








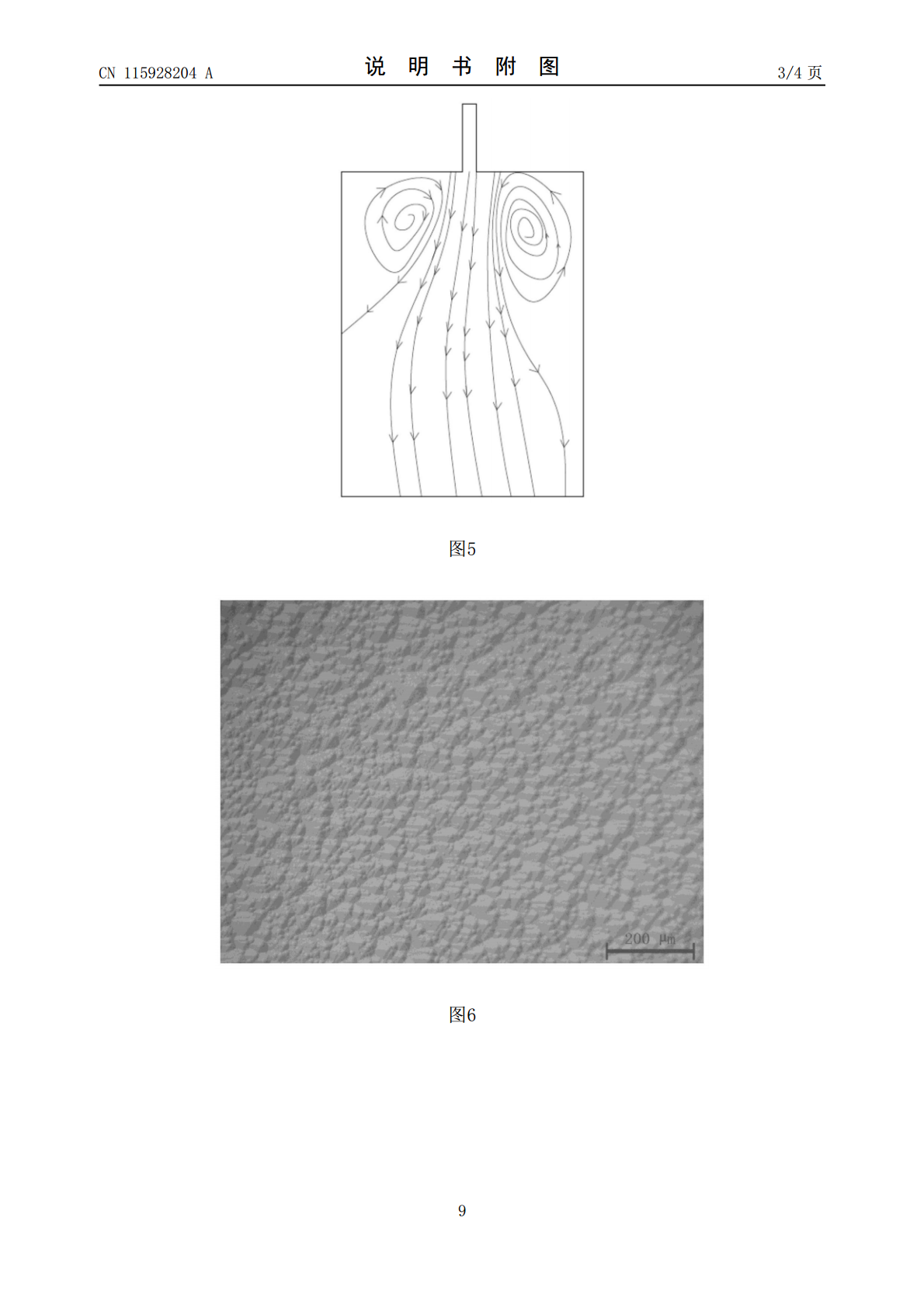

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种用于气相外延生长的防返流气体输运装置及方法.pdf
本发明提供了一种用于气相外延生长的防返流气体输运装置及方法,该装置呈喷头结构,至少包括多路管道进气口、多路气体输运管道、多路管道出气口、喷口多路管道出气口、一内置反应室、及多处变径防返流板。通过在多路管道出气口处设置防返流板,形成类漏斗式结构,避免因多路管道出气口横截面积小、流速大、压强小而导致出气管口受周围气体影响形成湍流乃至导致流体返流。本发明通过调控喷口多路管道出气口压强差的方法,避免喷口因单一管道出气口流速过大而出现虹吸返流现象。调控气流层流输运,可以有效减少预反应产生的颗粒,进而提高晶体质量。本

气相外延生长方法及带有外延层的基板的制备方法.pdf
本发明提供一种SiC基板的制造装置,其包括:在加热处理时使内部空间产生Si蒸气和C蒸气的SiC容器;和能够在Si环境下对所述SiC容器进行加热的高温真空炉。

一种用于气相外延生长半导体单晶材料的反应器.pdf
本发明提供了一种用于气相外延生长半导体单晶材料的反应器,本发明提供的反应器由挡板、进气管道、倒梯形圆台、出气孔、含金属前驱物输出管道、以及外壁组成;通过设置挡板将反应器分为上层空间和下层空间,通过在进气管道顶部设置开口,从而预留部分卤化物气体或者卤素气体在反应器的上层空间,使之与从下层空间逃逸到上层空间的金属源蒸汽反应,从而有效防止金属源混入到反应前驱物中,极大地提高了外延生长的晶体质量与产品良率;同时,通过设置进气管道的内侧壁开口、挡板、倒梯形圆台和出气孔,通过改变卤化物或卤素气体的流动方向及流程,增加

气相生长装置及外延晶片的制造方法.pdf
气相生长装置1包括反应炉2、导入通路8、多条流路15a、分支路14a、及分割通路16b。反应炉2通过原料气体使外延层气相生长于基板W。导入通路8包括:入口8a,其通往反应炉2内;出口8b,其位于入口8a的上方且较入口8a靠反应炉2侧并且到达反应炉2内;及阶部8c,其位于导入通路8内。多条流路15a为32条以上,且自入口8a延伸至入口8a的外侧。分支路14a使多条流路15a自入口8a侧朝向原料气体的上游侧呈竞赛状合流。分割通路16b为将导入通路8与多条流路15a对应地分割而成的通路,且分别与多条流路15a连

气体供应的处理方法、气体供应装置和外延生长设备.pdf
本发明公开了一种气体供应的处理方法、气体供应装置和外延生长设备,处理方法包括:在气体通入外延反应炉的反应腔之前,检测气体的含水量;根据气体的含水量判断控制气体输送至反应腔或去除气体中的水分后将气体输送至反应腔。在气体通入外延反应炉的反应腔之前,可以检测气体的含水量,在气体的含水量符合要求时,可以将气体直接通入外延反应炉的反应腔中;在气体的含水量不符合要求时,可以去除气体中的水分后,再将气体通入外延反应炉的反应腔中,可以有效控制通入外延反应炉的反应腔中气体水分,防止反应腔中水分含量升高影响晶圆的质量,提高外
