
一种终端沟槽结构的碳化硅二极管及其制备方法.pdf

音景****ka







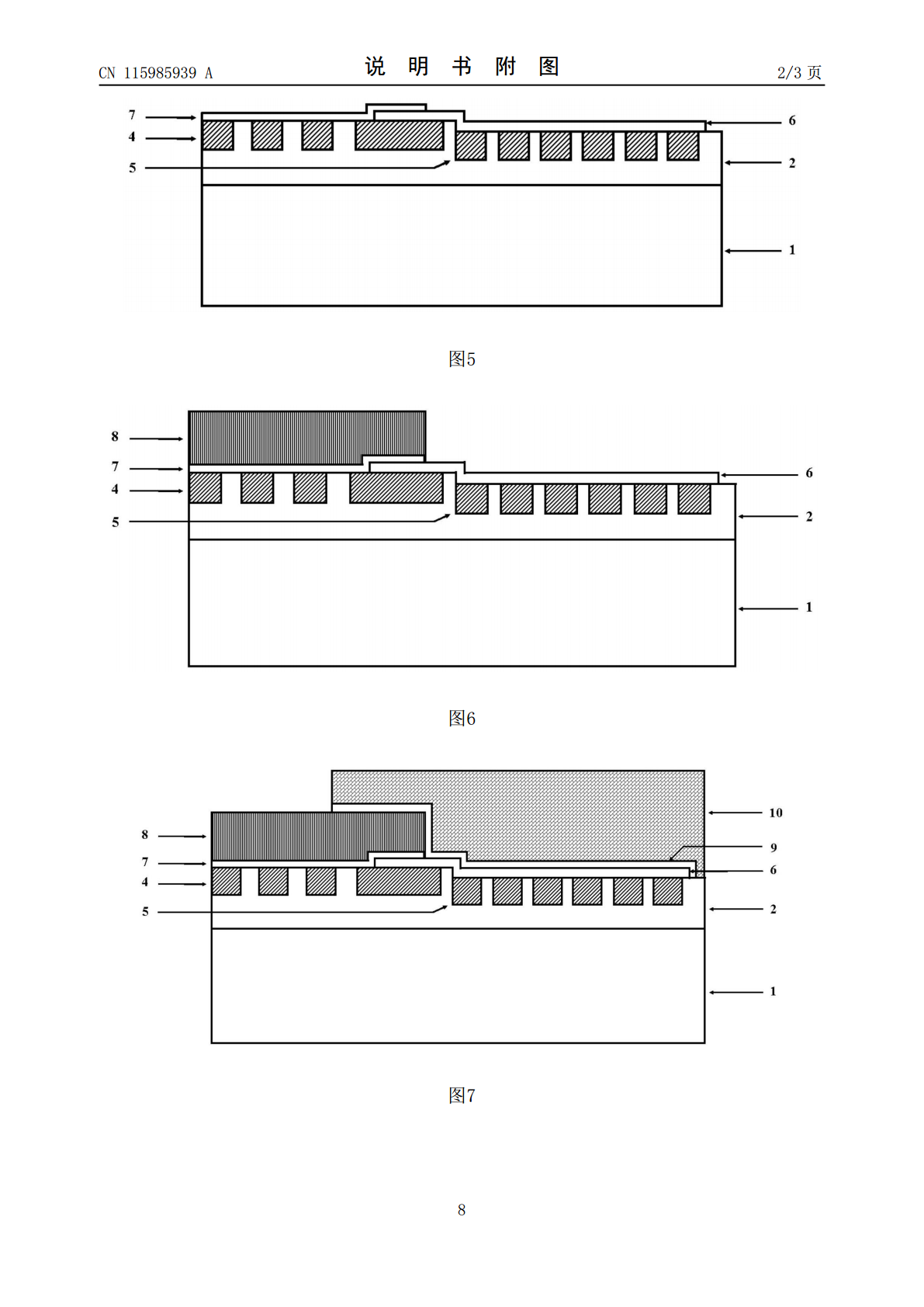
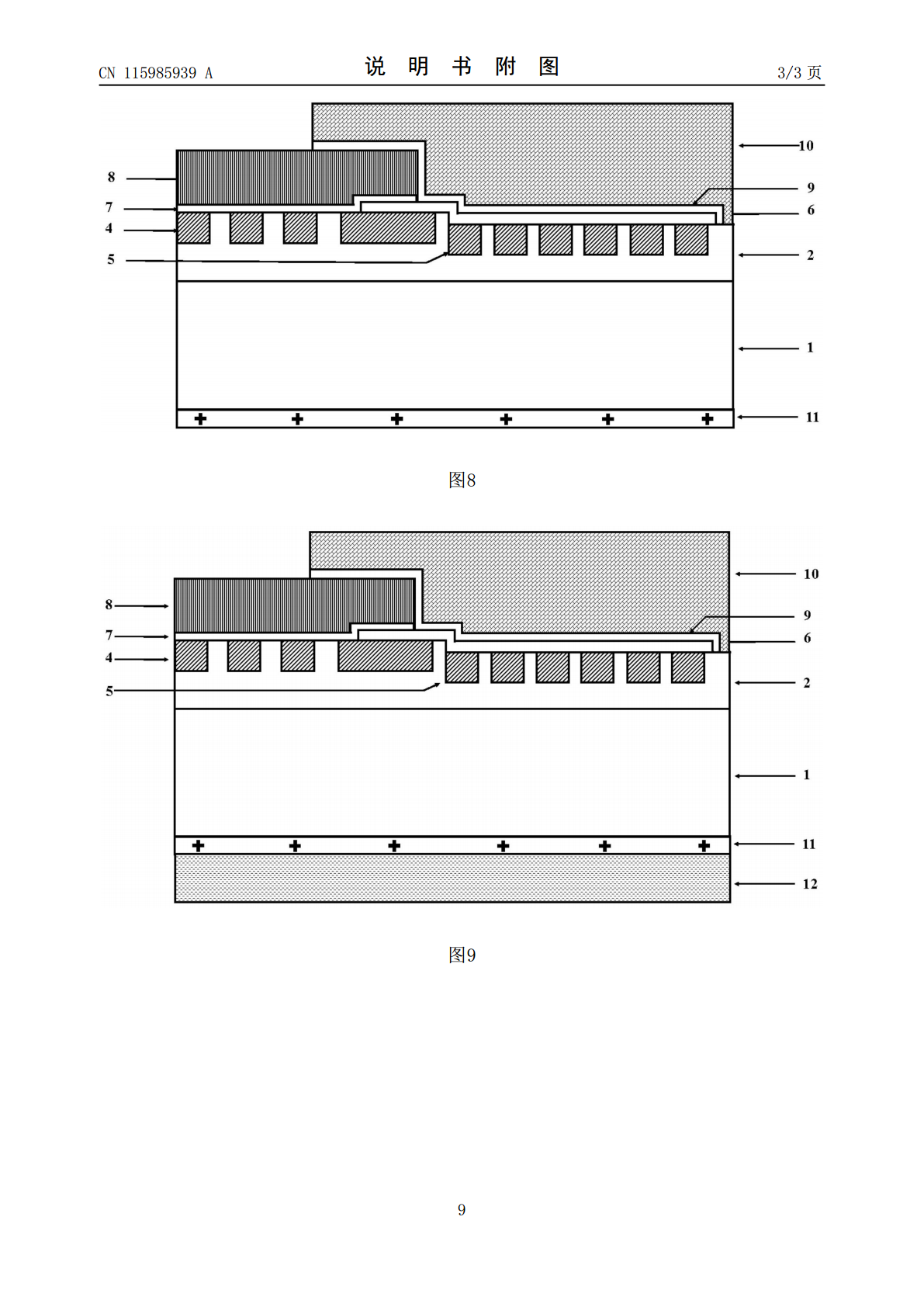
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种终端沟槽结构的碳化硅二极管及其制备方法.pdf
一种终端沟槽结构的碳化硅二极管及其制备方法,涉及碳化硅二极管器件。包括从下而上依次连接的背面加厚金属、背面欧姆接触金属、碳化硅衬底和碳化硅外延层;所述碳化硅外延层上设有交替设置的P型扩散区和P型分压环;所述碳化硅外延层的一侧设有从下而上依次设置的正面接触金属和正面加厚金属;所述碳化硅外延层的另一侧设有伸入正面接触金属下方的场氧;所述场氧的上方设有延伸至正面加厚金属上方的钝化层。具体的,所述钝化层包括从下而上依次设置的无机钝化层和有机钝化层。具体的,所述碳化硅衬底和碳化硅外延层导电类型均为N型。具体的,若干

一种沟槽终端结构肖特基器件及其制备方法.pdf
本发明公开了一种沟槽终端结构肖特基器件,本发明的半导体器件具有沟槽结构的终端,在器件中没有第二传导类型半导体材料,通过沟槽结构减缓器件反向偏压时在肖特基边缘电场的集中,简化了器件的制造流程;同时杜绝了传统器件在正向导电时第二传导类型半导体材料向漂移区少子的注入,提高了器件高频特性。

一种碳化硅器件结终端结构的制备方法及结终端结构.pdf
本发明提供一种碳化硅器件结终端结构的制备方法及结终端结构,包括:在碳化硅衬底层上形成外延层,并在所述外延层上沉积介质层;对所述介质层进行多次光刻和多次刻蚀处理,形成具有多种厚度的掩膜台阶;通过所述具有多种厚度的掩膜台阶向所述外延层进行离子注入,形成具有多种离子深度的结终端结构。通过具有多种厚度的掩膜台阶向外延层进行离子注入,形成具有多种离子深度的结终端结构,可以避免离子注入对碳化硅表面损伤,消除表面不可控的低浓度注入区域,提高了器件终端结构的可靠性和稳定性。

一种沟槽侧壁栅碳化硅MOSFET及其制备方法.pdf
本发明提供了一种沟槽侧壁栅碳化硅MOSFET及其制备方法,本发明通过在制备5‑10μm的宽碳化硅沟槽,沟槽间距2‑6μm;在宽沟槽内沉积侧壁保护层,向沟槽底部及非沟槽的中间部分进行加浓铝离子注入,去除侧壁掩膜层,涂布光刻胶,并无掩膜曝光,保留沟槽内的光刻胶,露出刻蚀掩膜层,清除刻蚀掩膜层,用光刻胶做氮离子注入阻挡层,并注入氮离子用来形成N+区;去除光刻胶,涂布碳膜,高温激活铝离子及氮离子,形成浓的P+,淡的P及浓的N+区。该结构的底部及Pwell中的P+区可以夹断栅氧拐角处的电场,保护栅氧不容易击穿;同时

一种基于缓冲层制备的沟槽型碳化硅MOSFET及其制备方法.pdf
本发明提供了一种基于缓冲层制备的沟槽型碳化硅MOSFET及其制备方法,其包括:漏极(10),碳化硅衬底(9),碳化硅N外延(8);所述碳化硅N外延(8)内部上方左侧包括Pwell区(3),所述沟槽区(32)包括自下而上的PplusBottom区(7)、栅氧区(6)和多晶硅区(5);源极(1)。本发明提供的基于缓冲层制备的沟槽型碳化硅MOSFET及其制备方法通过Pwell注入时施加注入缓冲层,形成深度大于沟槽的PwellBottom,而后进行PwellBottom区的碳化硅刻蚀,使沟槽底部保留了部分Pwel
