
一种芯片的双面封装结构及封装方法.pdf

Th****s3








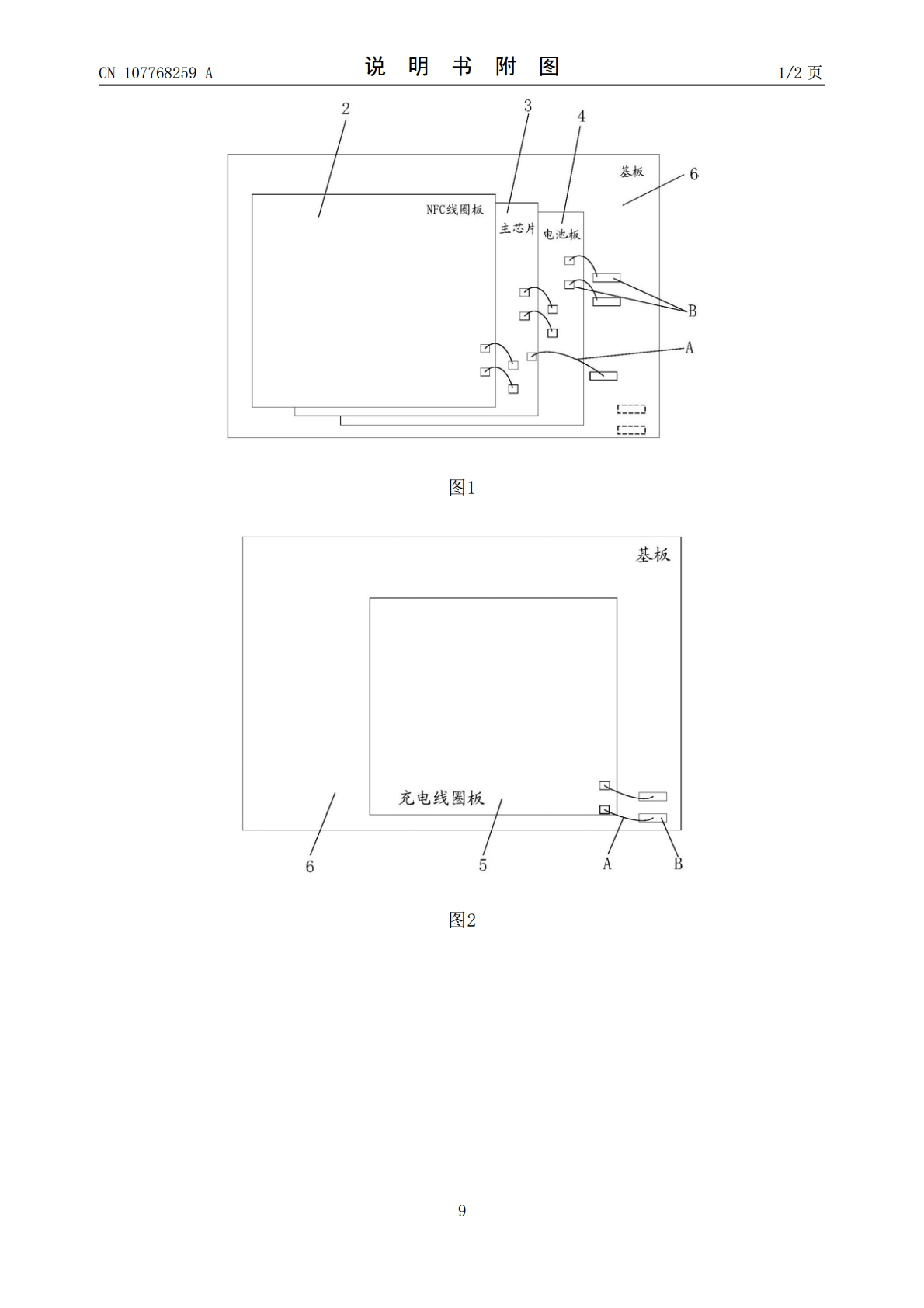

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种芯片的双面封装结构及封装方法.pdf
本发明提供一种芯片的双面封装结构,包括全封闭注塑体、NFC线圈膜或板、主芯片、电池板和无线充电线圈膜或板以及基板;所述NFC线圈膜或板、主芯片、电池板和无线充电线圈膜或板平铺分布在基板的正面并通过绝缘胶粘接固定,且分别与基板通过焊接线焊接后形成电气连接;焊接好的产品经注塑成型形成所述全封闭注塑体,且所述全封闭注塑体和基板的正面将NFC线圈膜或板、主芯片、电池板、无线充电线圈膜或板包裹在内,封闭后整体表面不留任何电气接口。本发明整个芯片没有任何对外的物理电气连接接口,可以使芯片工作于水或人体中等原来电子设备

芯片封装方法及芯片封装结构.pdf
本发明提供一种芯片的封装方法,其包括以下步骤:依次叠合一第一胶片、多个芯片及一第二胶片,压合使所述第一胶片与所述第二胶片固化,形成一封装体,使所述多个芯片埋入所述封装体中,其中,每个所述芯片上具有多个引脚,所述多个引脚远离所述第一胶片;自第二胶片远离第一胶片的表面向第二胶片内部形成与每个引脚一一对应的盲孔,每个引脚均从对应的盲孔露出;在所述盲孔的内壁形成与对应的引脚电导通的导电层;在每个盲孔上形成与对应盲孔的导电层电导通的金属块,形成封装基板;切割所述封装基板,形成多个包括有一个芯片的封装结构。本发明还涉

芯片封装方法及芯片封装结构.pdf
本发明提供一种芯片封装方法及芯片封装结构,在元件晶圆上形成有暴露用于晶片堆叠的预留位置表面的具有较低热膨胀系数的热膨胀系数过渡层,可以避免包封层对元件晶圆上的晶片和热膨胀系数过渡层包封后引起较大的热膨胀系数不匹配的问题,由此能够改善晶圆翘曲和应力引起的分层的问题,避免堆叠的晶片和包封层从元件晶圆上剥离,提高封装结构的性能;进一步的,所述热膨胀系数过渡层采用印刷电路板用阻焊剂材料形成,易于实现,不会产生副作用,并可以增强与后续包封层之间的粘附性,避免包封层从元件晶圆表面剥离。

芯片封装方法及芯片封装结构.pdf
本发明涉及一种芯片封装方法及芯片封装结构,所述芯片封装方法通过在载板的第一表面设置第一线路及第二表面设置第二线路;将芯片设置于所述载板,该芯片与第一线路和/或第二线路连接;设置第三线路;在对载板的第三表面和/或第四表面金属化形成金属部;对芯片进行包封,形成芯片封装结构;使得芯片封装结构内的所述芯片与第一线路电性连接;所述金属部与第一线路、第二线路及第三线路中的至少一个线路电性连接。通过所述金属部、第三线路及第一定位孔使得芯片与载板上的第一线路、第二线路连通,避免的现有技术中的通过引线将芯片与载板的线路导通

一种双面封装芯片散热结构.pdf
本发明公开了一种双面封装芯片散热结构,包括印制电路板,印制电路板的上方设有芯片基板,印制电路板和芯片基板之间通过第一焊球连接,芯片基板的上方设有散热盖,芯片基板的中间下方设置有一个或多个底面器件,底面器件与印制电路板之间设有热界面材料,多个第一焊球分布于热界面材料的周边。本发明的有益效果是:该双面封装芯片的上方通过散热盖实现向上的散热通道,下方的底面器件通过热界面材料及印制电路板形成向下的散热通道,达到减小封装热阻的目的,使得底面器件上的热量能够更快传导到印制电路板中,实现底面器件的快速散热,进而实现该双
