
一种改善散热的芯片封装结构及其制备方法.pdf

佳宁****么啦








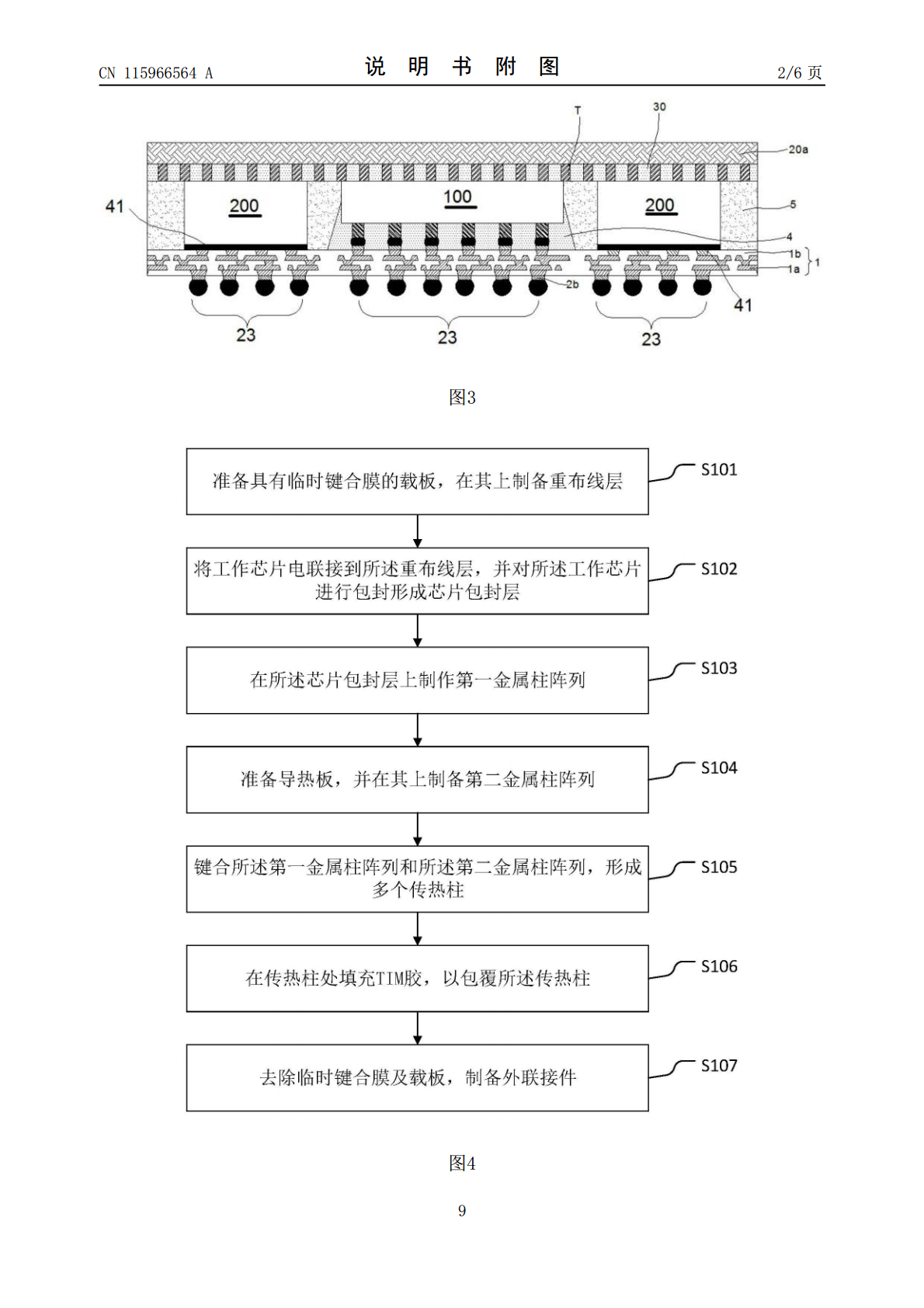

亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种改善散热的芯片封装结构及其制备方法.pdf
本发明公开了一种改善散热的芯片封装结构,包括依次连接的导热板、TIM胶、芯片包封层、重布线层以及外联接件,所述芯片包封层中设有工作芯片,所述工作芯片的无源面与所述TIM胶接触;所述TIM胶中设有多个传热柱,所述传热柱上下两端分别与所述芯片包封层和所述导热板连接;所述多个传热柱中至少有一部分设置在所述工作芯片的无源面上并与其形成硅基合金连接;所述传热柱与所述导热板形成金属合金或硅‑金属的共晶结构。本发明还公开了一种改善散热的芯片封装结构制备方法。本发明在工作芯片的无源面通过TIM胶包封的传热柱实现与导热板之

浆料及其制备方法和芯片散热结构的封装方法.pdf
本申请涉及电子封装互连技术领域,提供了一种浆料,包括第一焊接浆料和第二焊接浆料,第一焊接浆料和第二焊接浆料分别以各自独立的重量份计,第一焊接浆料包括:第一金属粉1~95份,且第一金属粉的熔点≤200℃,第一有机溶剂2~5份,第一活化剂0.5~1份,缓蚀剂0.3~1份,第一增稠剂0.1~1份;第二焊接浆料包括:微米金属粉10~80份,纳米金属粉10~70份,第二有机溶剂2~5份,第二活化剂0.5~1份,第二增稠剂0.1~1份。本申请提供的浆料由于第一焊接浆料中的第一金属粉的低温熔融流动性和润湿性好,可填充纳

芯片封装结构及其制备方法.pdf
本发明提供一种芯片封装结构及其制备方法,其中芯片封装结构包括:散热盖、加固片、芯片、辅助电子器件和基板;加固片、芯片和辅助电子器件固定设置于基板的同一表面上,散热盖位于加固片背离基板的一侧,散热盖与加固片固定连接,散热盖与芯片焊接,基板与加固片和散热盖合围成一安装腔,芯片位于安装腔内;加固片朝向基板的表面开设有容纳腔,辅助电子器件位于容纳腔内。本发明能够提高芯片封装的良率。

芯片封装结构及其制备方法.pdf
本发明提供一种芯片封装结构及其制备方法,芯片封装结构包括:一引线框架,所述引线框架具有至少一基岛及至少一引脚;至少一芯片,设置在所述基岛上,每一芯片的背面与所述基岛的承载面连接,每一芯片的有源面上设置有多个与芯片的焊垫连接的导电凸块;至少一导电柱,设置在所述引脚上表面;至少一重布线层,分别与所述导电凸块及所述导电柱连接,以将所述芯片的焊垫连接至所述引脚。本发明的优点在于,本发明芯片封装结构通过基岛散热,所述芯片通过导电凸块、重布线层及导电柱连接与引脚,具有高导热性能及良好的导电性能,适应大功率和高导热高导

芯片封装结构及其制备方法.pdf
本发明涉及一种芯片封装结构及其制备方法。该芯片封装结构的制备方法,包括:提供基板;于基板表面形成网状排布的金属线路,各金属线路的端部形成有间隔排布的第一沟槽,第一沟槽的延伸方向与金属线路的延伸方向相同,且第一沟槽具有第一深度;键合芯片于金属线路的表面;形成封装层,覆盖芯片和金属线路,得到第一中间封装结构;对第一中间封装结构执行切割工艺,于金属线路的端部形成具有第二深度的第二沟槽,第二深度小于第一深度。上述芯片封装结构的制备方法,可以在执行切割工艺后,在芯片封装结构中的金属线路端部仍保留一定深度的沟槽,便于
