
一种半导体材料点缺陷空位尺寸的检测方法.pdf

一条****发啊







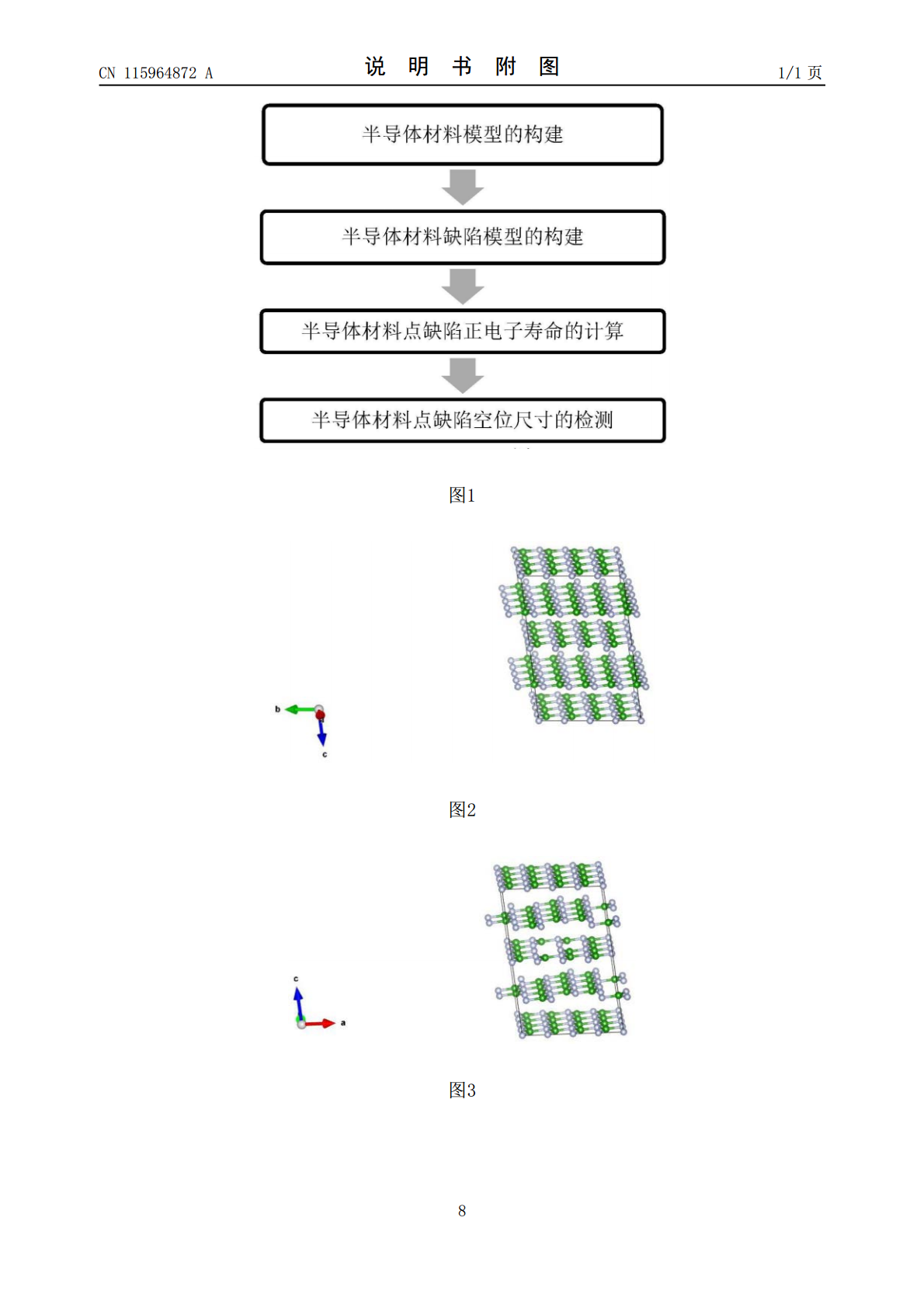
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种半导体材料点缺陷空位尺寸的检测方法.pdf
本发明公开了一种半导体材料点缺陷空位尺寸的检测方法,涉及半导体材料技术领域,具体为S1、半导体材料模型的构建S2、半导体材料缺陷模型的构建S3、孤立点缺陷正电子寿命的计算S4、半导体材料点缺陷空位尺寸的检测。该半导体材料点缺陷空位尺寸检测方法是基于第一性原理计算正电子的淹没寿命,可以及其精确的检测出半导体材料点缺陷的空位尺寸。

点缺陷空位的表征与计算的综述报告.docx
点缺陷空位的表征与计算的综述报告点缺陷空位是晶体中最简单的缺陷类型之一。它是指晶体中缺失了一个原子而形成的空位。点缺陷的存在对材料的性能和行为产生了重要影响。因此,了解点缺陷的表征和计算方法对于研究材料性能和行为的影响非常重要。点缺陷空位的表征通常有两种方法。一种是基于实验观察,另一种是基于计算模拟。实验观察可以使用传统的材料表征技术,如X射线衍射、光学显微镜和电子显微镜等。这些技术都有其独特的优点和限制。例如,X射线衍射技术通常可以给出点缺陷的位置和特定方向的晶体缺失信息,但无法提供关于缺陷类型和数量的

合成半导体纳米尺寸材料的方法.pdf
本发明涉及用于合成半导体纳米尺寸材料的方法,可通过所述方法获得的半导体纳米尺寸材料,光学介质和光学器件。在一个方面,本发明涉及用于合成基于魔幻尺寸簇(MSC)的包含至少三种组分的半导体纳米尺寸材料的方法。

一种大尺寸半导体材料电导率提升方法及器件.pdf
本申请公开了一种大尺寸半导体材料电导率提升方法及器件,包括:在基于缓冲层进行外延工艺之前,在缓冲层上外延电导层,其中外延的所述电导层材料与所述缓冲层晶格匹配;基于所述电导层,利用分子束外延工艺,外延吸收层。本申请实施例在吸收层下面增加具有高电导率导电层结构,用于提高大面阵红外焦平面探测器的偏压均匀性。使用分子束外延设备在材料外延中一次性完成材料外延制备,减少工艺时间并提升材料外延质量。

一种检测半导体碳化硅衬底中大尺寸微管的方法及装置.pdf
本申请公开了一种检测半导体碳化硅衬底中大尺寸微管的方法及装置。所述方法是在待测衬底上表面覆盖检测用液体,并使其上下表面形成气压差,通过检测该衬底的下表面和/或其支持物上是否存在所述检测用液体和/或其存在位置判断衬底中大尺寸微管数量和位置情况。所述装置包括样品吸附单元、抽真空装置、和连通所述样品吸附单元与所述抽真空装置的真空管道;所述样品吸附单元包括真空吸盘,其顶部设衬底吸附区域,所述附区域设多个开口朝上的环形槽,所述真空吸盘还设有通孔,所述通孔连通所述吸附区域和所述真空管道。本发明能准确判断半导体碳化硅衬
